在上一篇文章中,我們已經就溫度傳感的基本原理進行了介紹。本文將繼續這個話題,闡述系統溫度監測這個話題。
對于許多系統設計,有必要監測高功率組件(處理器、現場可編程門陣列、場效應晶體管)以確保系統和用戶安全。溫度讀數的精確性非常重要,因為它使設計人員能夠在提高性能的同時保持在安全限制內,或者通過避免在其他地方過度設計來降低系統成本。德州儀器 (TI) 的緊湊型高精度溫度傳感器產品系列可以更靠近這些關鍵組件放置,實現最精確的測量。

如何監測電路板溫度
電路中的溫度問題會影響系統性能并損壞昂貴組件。通過測量印刷電路板 (PCB) 中存在熱點或高耗電集成電路(IC) 的區域的溫度,有助于識別熱問題,進而及時采取預防或糾正措施。
您可能希望監測高耗電 IC(例如中央處理單元、專用 IC、現場可編程門陣列或數字信號處理器)的管芯溫度以動態調整其性能,或者可能希望監測功率級周圍的熱區,以便控制系統中的風扇速度或啟動安全系統關閉程序。最終目標是優化性能并保護昂貴的設備。
從 PCB 到溫度傳感器的熱傳遞
本地溫度傳感器測量它們自己的管芯溫度以確定特定區域的溫度。因此,了解管芯與傳感器周圍物體或環境之間的主要溫度傳導路徑至關重要。主要通過兩種路徑導熱:通過連接到封裝的管芯連接焊盤 (DAP)或通過封裝引線引腳。DAP(如果存在)提供 PCB 和管芯之間最主要的導熱路徑。
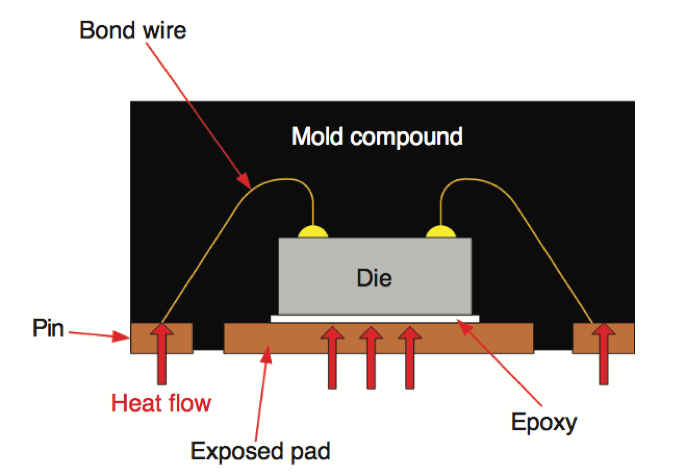
帶有 DAP 的封裝
如果封裝類型不包含 DAP,則引線和引腳提供最主要的導熱路徑。
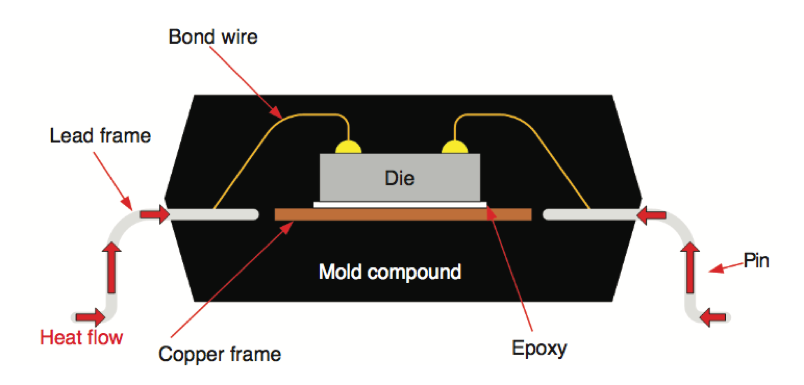
不帶 DAP 的封裝
模塑化合物提供額外的導熱路徑,但由于其低導熱性,通過模塑化合物本身進行的任何熱傳遞均比通過引線或DAP進行的熱傳遞更慢。
熱響應
封裝類型決定了溫度傳感器對溫度變化的響應速度。下圖顯示了用于溫度測量的不同類別的選定表面貼裝技術封裝類型的相對熱響應速率。
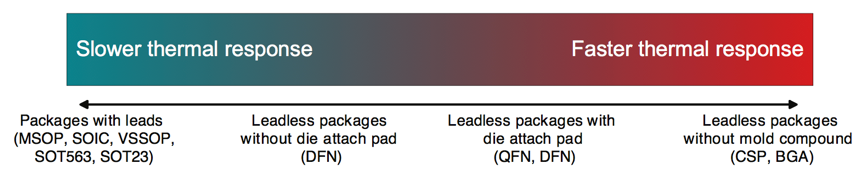
不帶模塑化合物的封裝(芯片級封裝、管芯尺寸球柵陣列封裝)和帶有 DAP 的封裝(四方扁平無引線 [QFN] 封裝、雙邊扁平無引線 [DFN] 封裝)是專為需要從 PCB 快速進行熱傳遞的應用而設計的,而不帶 DAP 的封裝是專為需要較慢響應速率的應用而設計的。快速的熱響應速率使溫度傳感器能夠快速響應任何溫度變化,從而提供準確的讀數。
設計準則 — 底部安裝
傳感器位置應盡可能靠近要監測的熱源。應避免在發熱IC 和溫度傳感器之間的 PCB 上穿孔或切口,因為這可能會減慢或阻止熱響應。如果可能,請將溫度監測器安裝在PCB 底部直接位于熱源下方。
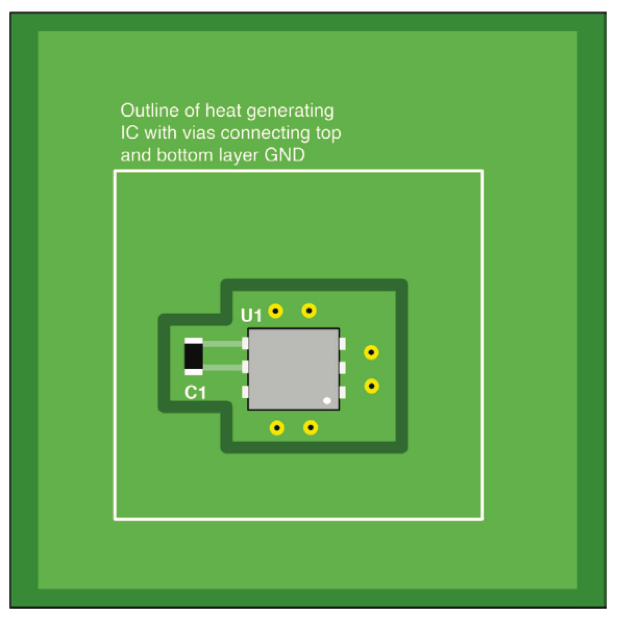
傳感器安裝在熱源的另一側
TI 建議使用過孔將熱量從 PCB 的一側快速傳遞到另一側,因為與 FR-4 相比,過孔具有更好的銅導熱性。可以使用盡可能多的并行過孔或填充式傳導過孔,將熱量從熱源傳遞到溫度監測器,以便在兩個 IC 之間實現快速熱平衡。帶有 DAP 的 QFN 或 DFN 封裝有助于進一步縮短過孔與傳感器管芯之間的熱阻路徑。
設計準則 — 地層注意事項
如果將溫度傳感器放置在熱源的另一側是不切實際或不劃算的做法,請將其放置在盡可能靠近熱源的同一側。

共用的地層有助于實現熱平衡
在熱源和溫度監測器之間建立熱平衡的最有效方法是使用地層。應使用從熱源延伸到溫度傳感器的堅固地層。
結論
在具有熱電區域或高耗電 IC 的 PCB 設計中,溫度監測至關重要。必須評估本地溫度傳感器的選擇是否符合相關設計的系統要求和保護方案。

應考慮傳感器位置和高導熱率路徑,以此在傳感器和發熱元件之間建立快速熱平衡。

