據日經亞洲評論報道,臺積電正與谷歌等美國科技巨頭合作,開發新的芯片封裝技術。
隨著摩爾定律放緩,縮小晶體管之間的空間變得越來越困難,封裝技術的創新變得尤為重要。
臺積電現正采用一種名為SoIC的新3D技術,垂直與水平地進行芯片封裝,可以將處理器、內存和傳感器等幾種不同類型的芯片堆疊和連接在一起。這種方法使整個芯片組更小,更強大,更節能。
知情人士向日經新聞透露,臺積電計劃在其正在臺灣苗栗市興建的芯片封裝廠使用其新型3D堆疊技術。消息人士稱,谷歌和AMD將成為其首批SoIC芯片的客戶,并將幫助臺積電對這些芯片進行測試和認證。該工廠的建設計劃明年完工,將于2022年開始大規模生產。
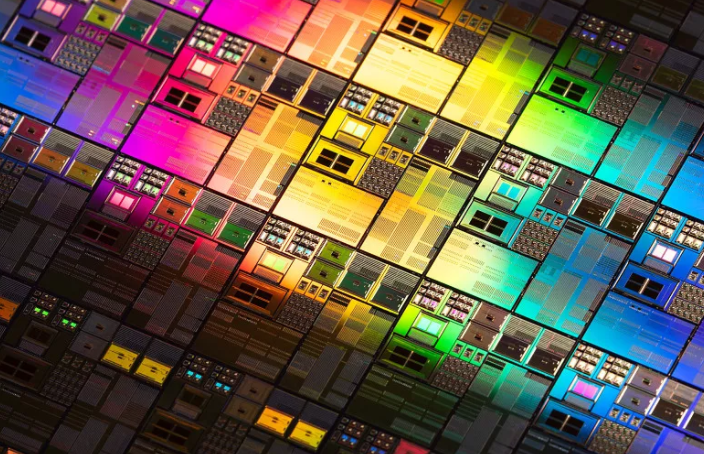
知情人士表示,臺積電當然不會試圖取代所有傳統的芯片封裝廠商,但它的目標是服務于那些處于金字塔頂端的高端客戶,這樣那些財力雄厚的芯片開發商,如蘋果、谷歌、AMD和英偉達,就不會把臺積電留給競爭對手。
另一位芯片封裝行業專家表示:“這些新的芯片堆疊技術需要先進的芯片制造專業知識以及大量的計算機模擬來實現精確的堆疊,因此傳統芯片封裝供應商很難介入。”
知情人士告訴日經,谷歌計劃將SolC工藝生產的芯片用于自動駕駛系統和其他應用。谷歌在設計自己的芯片方面相對較新,目前在其數據中心服務器中用于人工智能計算。
另據多名消息人士透露,中芯國際也在考慮建立類似的先進芯片封裝能力,并已向臺積電的一些供應商訂購設備,以運營一條小規模的先進封裝生產線。
臺積電拒絕就具體客戶置評,但對日經表示,由于計算任務比過去更加多樣化,要求也更高,半導體和封裝技術有必要共同發展。客戶對先進芯片封裝服務的需求正在增加。
本站內容除特別聲明的原創文章之外,轉載內容只為傳遞更多信息,并不代表本網站贊同其觀點。轉載的所有的文章、圖片、音/視頻文件等資料的版權歸版權所有權人所有。本站采用的非本站原創文章及圖片等內容無法一一聯系確認版權者。如涉及作品內容、版權和其它問題,請及時通過電子郵件或電話通知我們,以便迅速采取適當措施,避免給雙方造成不必要的經濟損失。聯系電話:010-82306118;郵箱:[email protected]。

