7 月 11 日消息,日本信越化學 6 月 12 日宣布開發出新型半導體后端制造設備,可直接在封裝基板上構建符合 2.5D 先進封裝集成需求的電路圖案。

▲ 蝕刻圖案
這意味著可在 HBM 內存集成工藝中完全省略昂貴的中介層(Interposer),在大大降低生產成本的同時也縮短了先進封裝流程。
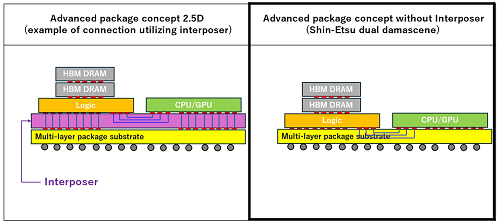
▲ 2.5D 集成結構對比
信越表示,該新型后端設備采用準分子激光器蝕刻布線,無需光刻工藝就能批量形成大面積的復雜電路圖案,達到了傳統制造路線無法企及的精細度。
結合信越化學開發的光掩模坯和特殊鏡頭,新型激光后端制造設備可一次性加工 100mm 見方或更大的區域。
根據《日經新聞》報道,信越化學目標 2028 年量產這款設備,力爭實現 200~300 億日元(IT之家備注:當前約 9.02 ~ 13.53 億元人民幣)相關年銷售額。

本站內容除特別聲明的原創文章之外,轉載內容只為傳遞更多信息,并不代表本網站贊同其觀點。轉載的所有的文章、圖片、音/視頻文件等資料的版權歸版權所有權人所有。本站采用的非本站原創文章及圖片等內容無法一一聯系確認版權者。如涉及作品內容、版權和其它問題,請及時通過電子郵件或電話通知我們,以便迅速采取適當措施,避免給雙方造成不必要的經濟損失。聯系電話:010-82306118;郵箱:[email protected]。

