4月26日消息,在近日舉辦的北美技術論壇上,臺積電首次公開了N2 2nm工藝的缺陷率(D0)情況,比此前的7nm、5nm、3nm等歷代工藝都好的多。
臺積電沒有給出具體數據,只是比較了幾個工藝缺陷率隨時間變化的趨勢。

臺積電N2首次引入了GAAFET全環繞晶體管,目前距離大規模量產還有2個季度,也就是要等到年底。
N2試產近2個月來,缺陷率和同期的N5/N4差不多,還稍微低一點,同時顯著優于N7/N6、N3/N3P。
從試產到量產半年的時間周期內,N7/N6的綜合缺陷率是最高的,N3/N3P從量產開始就低得多了,N5/N4情況更好,從試產開始就明顯更低。
N2如果能延續N5/N4的趨勢,前景無疑是非常光明的。
臺積電還指出,一種工藝的缺陷率能否快速降低,除了取決于本身的設計和技術,也要看制造芯片數量、產能規模,越多越大就越容易發現缺陷并改進。
臺積電N2已流片的芯片數量就明顯更多,也是其能夠快速降低缺陷率的關鍵原因。
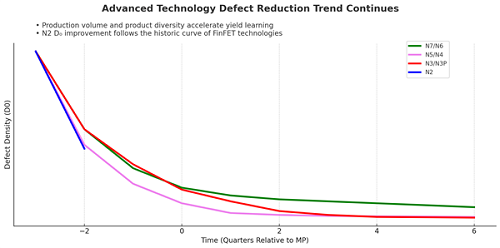

本站內容除特別聲明的原創文章之外,轉載內容只為傳遞更多信息,并不代表本網站贊同其觀點。轉載的所有的文章、圖片、音/視頻文件等資料的版權歸版權所有權人所有。本站采用的非本站原創文章及圖片等內容無法一一聯系確認版權者。如涉及作品內容、版權和其它問題,請及時通過電子郵件或電話通知我們,以便迅速采取適當措施,避免給雙方造成不必要的經濟損失。聯系電話:010-82306118;郵箱:[email protected]。

